SSDПЁ ЛчПыЕЧДТ ГНЕх ЧУЗЁНУРЧ 3D ОЦХАХиУГ ЕЕРдРИЗЮ РЭМїЧиСј ЙнЕЕУМРЧ 3D БИСЖДТ CPUПЭ ИоИ№ИЎРЧ ХыЧеРЛ КёЗдЧи ДйОчЧб КаОпПЁМРЧ 3D ШАЁ НУЕЕЕЧАэ РжДй.

ЦЏШї, ГНЕхЧУЗЁНУПЭ ААРК ДмРЯ ФФЦїГЭЦЎПЁМ CPUПЭ ИоИ№ИЎРЧ ХыЧе ААРК ПЉЗЏ ФФЦїГЭЦЎИІ ЧЯГЊРЧ ФЈПЁ ѧОЧв АцПь ЙпП СІОюИІ АэЙЮЧв Мі ЙлПЁ ОјДТЕЅ, Purdue ДыЧаПЁМ ТїММДы 3D ФЈРЛ РЇЧб Ф№ИЕ ХзХЉДаРЛ ЙпЧЅЧпДй.
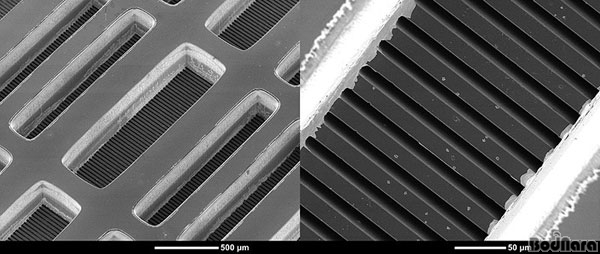
ЧиДч ХзХЉДаРК БтКЛРћРИЗЮ АЂ ЗЙРЬОю ЛчРЬПЁ МіЗЉ Ф№ЗЏРЧ ПіХЭ КэЗЯПЁ ЕЕРдЕШ АЭАњ ААРК ИЖРЬХЉЗЮ УЄГЮРЛ Л§МКЧи ГУАЂМіИІ ШхИЃАд ЧЯДТ АЭРИЗЮ, ЙпЧЅПЁ ЕћИЃИщ 1cm² Дч 1 kWРЧ ЙпППЁ ДыРРЧв Мі РжДй.
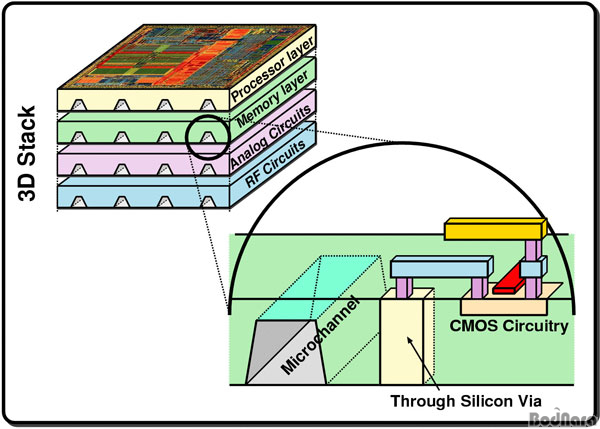
ЧиДч ЙцНФРЬ ЕЕРдЕЩ АцПь БтСИ Ф№ИЕ ЙцНФРЬ ФЈ ЧЅИщРЧ ЙпПИИ ШПАњРћРИЗЮ ГУАЂЧв Мі РжДТ АЭАњ ДоИЎ РќУМ ЗЙРЬОюПЁ БеЕюЧб Ф№ИЕ ШПАњИІ ЙпШжЧв Мі РжРЛ АЭРИЗЮ БтДыЕЧИч, АјАЃ ШПРВАњ АэМКДЩРЬ ЕПНУПЁ ПфБИЕЧДТ МЙіГЊ НДЦлФФЧЛХЭ КаОпПЁ РЏПыЧб БтМњРЬ ЕЩ АЭРИЗЮ ЦЧДмЕШДй. |